Ներածություն սիլիցիումի կարբիդին
Սիլիցիումի կարբիդը (SiC) բարդ կիսահաղորդչային նյութ է, որը կազմված է ածխածնից և սիլիցիումից, որը իդեալական նյութերից մեկն է բարձր ջերմաստիճանի, բարձր հաճախականության, բարձր հզորության և բարձր լարման սարքեր պատրաստելու համար: Համեմատած ավանդական սիլիցիումային նյութի (Si) հետ, սիլիցիումի կարբիդի արգելակային գոտին 3 անգամ մեծ է սիլիցիումից: Ջերմահաղորդականությունը 4-5 անգամ մեծ է սիլիցիումից. քայքայման լարումը 8-10 անգամ մեծ է սիլիցիումից. էլեկտրոնային հագեցվածության դրիֆտի արագությունը 2-3 անգամ մեծ է սիլիցիումից, ինչը բավարարում է ժամանակակից արդյունաբերության բարձր հզորության, բարձր լարման և բարձր հաճախականության պահանջները: Այն հիմնականում օգտագործվում է բարձր արագության, բարձր հաճախականության, բարձր հզորության և լույս արձակող էլեկտրոնային բաղադրիչների արտադրության համար: Հետին կիրառման ոլորտները ներառում են խելացի ցանցեր, նոր էներգետիկ տրանսպորտային միջոցներ, ֆոտովոլտային քամու էներգիա, 5G կապ և այլն: Սիլիցիումի կարբիդային դիոդները և MOSFET-ները առևտրային կիրառություն ունեն:

Բարձր ջերմաստիճանային դիմադրություն։ Սիլիցիումի կարբիդի արգելակային գոտու լայնությունը 2-3 անգամ մեծ է սիլիցիումի լայնությունից, էլեկտրոնները հեշտությամբ չեն անցնում բարձր ջերմաստիճաններում և կարող են դիմակայել ավելի բարձր աշխատանքային ջերմաստիճաններին, իսկ սիլիցիումի կարբիդի ջերմային հաղորդունակությունը 4-5 անգամ ավելի մեծ է, քան սիլիցիումինը, ինչը հեշտացնում է սարքի ջերմափոխանակումը և բարձրացնում աշխատանքային սահմանային ջերմաստիճանը։ Բարձր ջերմաստիճանային դիմադրությունը կարող է զգալիորեն մեծացնել հզորության խտությունը՝ միաժամանակ նվազեցնելով սառեցման համակարգի պահանջները, դարձնելով տերմինալը ավելի թեթև և փոքր։
Դիմանալ բարձր ճնշմանը։ Սիլիցիումի կարբիդի էլեկտրական դաշտի քայքայման ուժը 10 անգամ ավելի մեծ է, քան սիլիցիումինը, որը կարող է դիմակայել ավելի բարձր լարումների և ավելի հարմար է բարձր լարման սարքերի համար։
Բարձր հաճախականության դիմադրություն։ Սիլիցիումի կարբիդն ունի սիլիցիումի համեմատ կրկնակի հագեցած էլեկտրոնների շեղման արագություն, ինչը հանգեցնում է անջատման գործընթացում հոսանքի պոչերի բացակայությանը, ինչը կարող է արդյունավետորեն բարելավել սարքի անջատման հաճախականությունը և իրականացնել սարքի մանրացումը։
Ցածր էներգիայի կորուստ։ Սիլիկոնային նյութի համեմատ, սիլիցիումի կարբիդն ունի շատ ցածր միացման դիմադրություն և ցածր միացման կորուստ։ Միևնույն ժամանակ, սիլիցիումի կարբիդի բարձր գոտիական բացվածքի լայնությունը զգալիորեն նվազեցնում է արտահոսքի հոսանքը և հզորության կորուստը։ Բացի այդ, սիլիցիումի կարբիդային սարքը անջատման գործընթացում հոսանքի հետընթացի երևույթ չունի, և անջատման կորուստը ցածր է։
Սիլիկոնային կարբիդի արդյունաբերական շղթա
Այն հիմնականում ներառում է հիմք, էպիտաքսիա, սարքի նախագծում, արտադրություն, կնքում և այլն: Սիլիցիումի կարբիդը նյութից մինչև կիսահաղորդչային էլեկտրական սարք անցնում է միաբյուրեղային աճի, ձուլակտորի կտրման, էպիտաքսիալ աճի, վաֆլիի նախագծման, արտադրության, փաթեթավորման և այլ գործընթացների: Սիլիցիումի կարբիդի փոշու սինթեզից հետո նախ պատրաստվում է սիլիցիումի կարբիդային ձուլակտորը, այնուհետև սիլիցիումի կարբիդային հիմքը ստացվում է կտրատման, հղկման և փայլեցման միջոցով, իսկ էպիտաքսիալ թերթը ստացվում է էպիտաքսիալ աճեցման միջոցով: Էպիտաքսիալ վաֆլին պատրաստվում է սիլիցիումի կարբիդից լիտոգրաֆիայի, փորագրության, իոնային իմպլանտացիայի, մետաղի պասիվացման և այլ գործընթացների միջոցով, վաֆլին կտրվում է դրոշմիչի մեջ, սարքը փաթեթավորվում է, և սարքը միացվում է հատուկ պատյանի մեջ և հավաքվում մոդուլի մեջ:
Արդյունաբերական շղթայի վերին հոսանք 1. սուբստրատ - բյուրեղների աճը հիմնական գործընթացային օղակն է
Սիլիցիումի կարբիդային հիմքը կազմում է սիլիցիումի կարբիդային սարքերի արժեքի մոտ 47%-ը, որն ունի արտադրական ամենաբարձր տեխնիկական խոչընդոտները, ամենամեծ արժեքը և SiC-ի ապագա լայնածավալ արդյունաբերականացման միջուկն է։
Էլեկտրաքիմիական հատկությունների տարբերությունների տեսանկյունից, սիլիցիումի կարբիդային հիմքերը կարելի է բաժանել հաղորդիչ հիմքերի (դիմադրության տիրույթ 15~30 մΩ·սմ) և կիսամեկուսիչ հիմքերի (դիմադրությունը 105 Ω·սմ-ից բարձր): Այս երկու տեսակի հիմքերը օգտագործվում են առանձին սարքերի, ինչպիսիք են համապատասխանաբար հզորության սարքերը և ռադիոհաճախականության սարքերը, արտադրության համար՝ էպիտաքսիալ աճեցումից հետո: Դրանցից կիսամեկուսիչ սիլիցիումի կարբիդային հիմքը հիմնականում օգտագործվում է գալիումի նիտրիդային ՌՖ սարքերի, ֆոտոէլեկտրական սարքերի և այլնի արտադրության մեջ: Կիսամեկուսացված SIC հիմքի վրա gan էպիտաքսիալ շերտ աճեցնելով՝ պատրաստվում է sic էպիտաքսիալ թիթեղ, որը կարող է հետագայում պատրաստվել HEMT gan իզոնիտրիդային ՌՖ սարքերի: Հաղորդիչ սիլիցիումի կարբիդային հիմքը հիմնականում օգտագործվում է հզորության սարքերի արտադրության մեջ: Ի տարբերություն ավանդական սիլիցիումային էներգաբլոկների արտադրության գործընթացի, սիլիցիումի կարբիդային էներգաբլոկը չի կարող անմիջապես պատրաստվել սիլիցիումի կարբիդային հիմքի վրա, սիլիցիումի կարբիդային էպիտաքսիալ շերտը պետք է աճեցվի հաղորդիչ հիմքի վրա՝ սիլիցիումի կարբիդային էպիտաքսիալ թերթիկ ստանալու համար, և էպիտաքսիալ շերտը պատրաստվում է Շոտկիի դիոդի, MOSFET-ի, IGBT-ի և այլ էներգաբլոկների վրա։
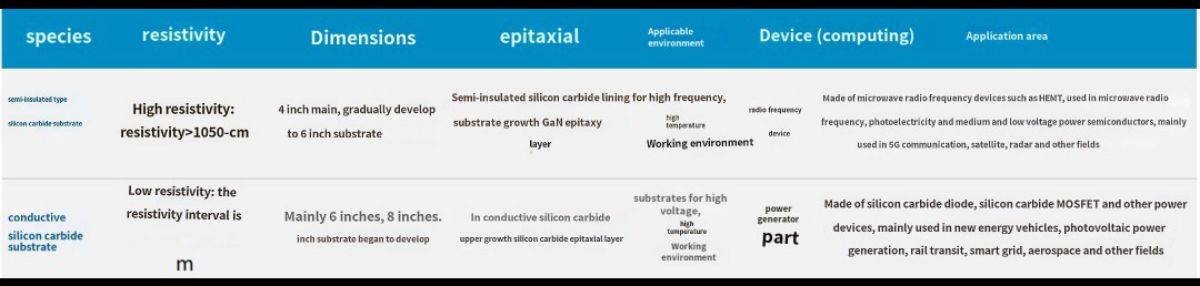
Սիլիցիումի կարբիդի փոշին սինթեզվել է բարձր մաքրության ածխածնային փոշուց և բարձր մաքրության սիլիցիումի փոշուց, և տարբեր չափերի սիլիցիումի կարբիդի ձուլակտորներ աճեցվել են հատուկ ջերմաստիճանային դաշտում, որից հետո սիլիցիումի կարբիդի հիմքը ստացվել է բազմաթիվ մշակման գործընթացների միջոցով: Հիմնական գործընթացը ներառում է.
Հումքի սինթեզ. Բարձր մաքրության սիլիցիումի փոշին + տոները խառնվում են ըստ բանաձևի, և ռեակցիան իրականացվում է ռեակցիայի խցիկում 2000°C-ից բարձր բարձր ջերմաստիճանի պայմաններում՝ սիլիցիումի կարբիդի մասնիկներ սինթեզելու համար՝ որոշակի բյուրեղային տեսակի և մասնիկի չափի: Այնուհետև, մանրացման, զտման, մաքրման և այլ գործընթացների միջոցով, բարձր մաքրության սիլիցիումի կարբիդի փոշու հումքի պահանջները բավարարելու համար:
Բյուրեղների աճեցումը սիլիցիումի կարբիդային հիմքի արտադրության հիմնական գործընթացն է, որը որոշում է սիլիցիումի կարբիդային հիմքի էլեկտրական հատկությունները: Ներկայումս բյուրեղների աճի հիմնական մեթոդներն են ֆիզիկական գոլորշու փոխանցումը (PVT), բարձր ջերմաստիճանի քիմիական գոլորշու նստեցումը (HT-CVD) և հեղուկ փուլի էպիտաքսիան (LPE): Դրանց թվում PVT մեթոդը SiC հիմքի առևտրային աճի հիմնական մեթոդն է, որն ունի ամենաբարձր տեխնիկական հասունությունը և ամենատարածված կիրառությունն ունի ճարտարագիտության մեջ:

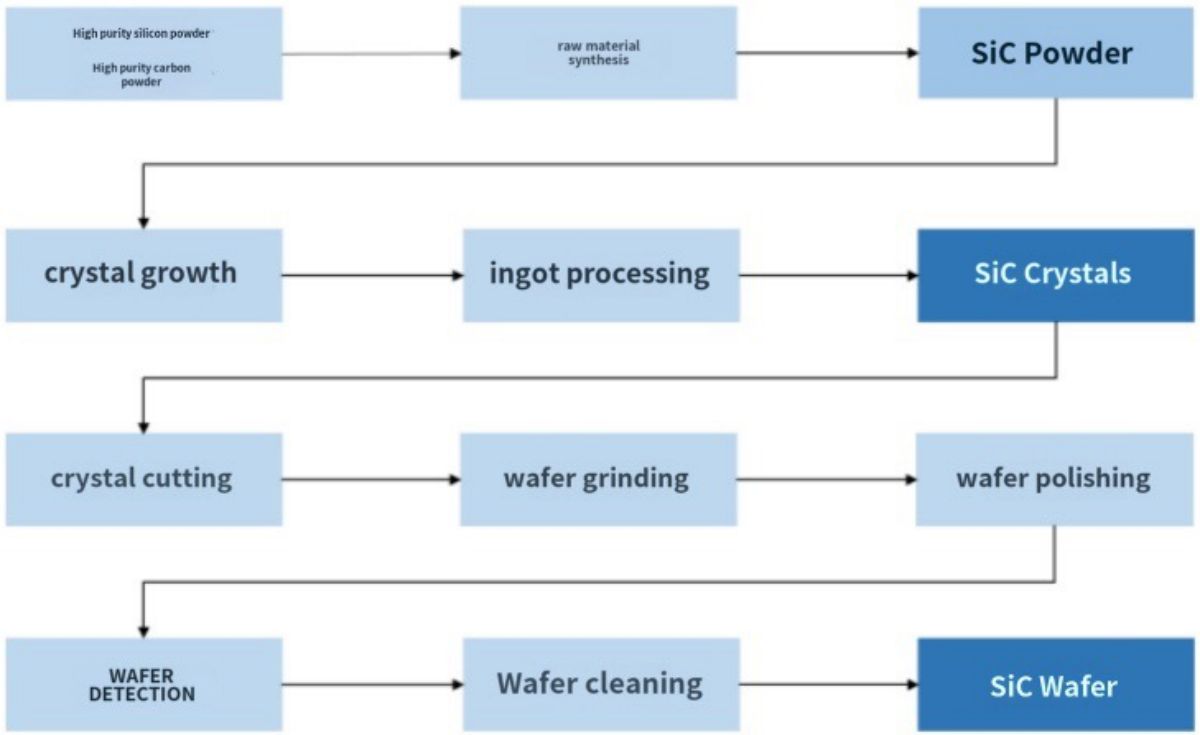
SiC հիմքի պատրաստումը դժվար է, ինչը հանգեցնում է դրա բարձր գնի։
Ջերմաստիճանային դաշտի կառավարումը դժվար է. Si բյուրեղային ձողերի աճեցման համար անհրաժեշտ է ընդամենը 1500℃, մինչդեռ SiC բյուրեղային ձողերը պետք է աճեցվեն 2000℃-ից բարձր ջերմաստիճանում, և կան ավելի քան 250 SiC իզոմերներ, բայց հիմնական 4H-SiC միաբյուրեղային կառուցվածքը, որը նախատեսված է էլեկտրական սարքերի արտադրության համար, եթե ճշգրիտ կառավարում չկա, կստանա այլ բյուրեղային կառուցվածքներ: Բացի այդ, հալոցքի ջերմաստիճանի գրադիենտը որոշում է SiC սուբլիմացիայի փոխանցման արագությունը և գազային ատոմների դասավորությունն ու աճի ռեժիմը բյուրեղային միջերեսի վրա, ինչը ազդում է բյուրեղի աճի արագության և բյուրեղի որակի վրա, ուստի անհրաժեշտ է ստեղծել ջերմաստիճանային դաշտի համակարգված կառավարման տեխնոլոգիա: Si նյութերի համեմատ, SiC արտադրության տարբերությունը նաև բարձր ջերմաստիճանային գործընթացներում է, ինչպիսիք են բարձր ջերմաստիճանային իոնային իմպլանտացիան, բարձր ջերմաստիճանային օքսիդացումը, բարձր ջերմաստիճանային ակտիվացումը և այս բարձր ջերմաստիճանային գործընթացների համար անհրաժեշտ կոշտ դիմակի գործընթացը:
Դանդաղ բյուրեղային աճ. Si բյուրեղային ձողի աճի տեմպը կարող է հասնել 30-150 մմ/ժ-ի, իսկ 1-3 մ սիլիցիումային բյուրեղային ձողի արտադրությունը տևում է ընդամենը մոտ 1 օր։ Օրինակ՝ PVT մեթոդով SiC բյուրեղային ձողի աճի տեմպը մոտ 0.2-0.4 մմ/ժ է, 3-6 սմ-ից պակաս աճելու համար անհրաժեշտ է 7 օր, աճի տեմպը կազմում է սիլիցիումային նյութի 1%-ից պակաս, արտադրական հզորությունը խիստ սահմանափակ է։
Բարձր արտադրանքի պարամետրեր և ցածր արտադրողականություն. SiC հիմքի հիմնական պարամետրերն են միկրոխողովակների խտությունը, տեղաշարժերի խտությունը, դիմադրությունը, ծռումը, մակերեսի կոպտությունը և այլն: Ատոմները փակ բարձր ջերմաստիճանի խցիկում դասավորելու և բյուրեղների աճն ավարտելու համար բարդ համակարգ է, միաժամանակ վերահսկելով պարամետրերի ինդեքսները:
Նյութը ունի բարձր կարծրություն, բարձր փխրունություն, երկար կտրման ժամանակ և բարձր մաշվածություն. SiC Mohs-ի 9.25 կարծրությունը երկրորդն է միայն ադամանդից հետո, ինչը հանգեցնում է կտրման, հղկման և փայլեցման դժվարության զգալի աճի, և 3 սմ հաստությամբ ձուլակտորի 35-40 կտոր կտրելու համար պահանջվում է մոտ 120 ժամ: Բացի այդ, SiC-ի բարձր փխրունության պատճառով, թիթեղների մշակման մաշվածությունն ավելի մեծ կլինի, և ելքային հարաբերակցությունը կկազմի ընդամենը մոտ 60%:
Զարգացման միտում. Չափի աճ + գնի նվազում
Համաշխարհային SiC շուկայի 6 դյույմանոց ծավալի արտադրական գիծը հասունանում է, և առաջատար ընկերությունները մուտք են գործել 8 դյույմանոց շուկա: Ներքին զարգացման նախագծերը հիմնականում 6 դյույմանոց են: Ներկայումս, չնայած տեղական ընկերությունների մեծ մասը դեռևս հիմնված է 4 դյույմանոց արտադրական գծերի վրա, արդյունաբերությունը աստիճանաբար ընդլայնվում է մինչև 6 դյույմանոց, 6 դյույմանոց օժանդակ սարքավորումների տեխնոլոգիայի հասունացման հետ մեկտեղ, ներքին SiC ենթաշերտի տեխնոլոգիան նույնպես աստիճանաբար բարելավում է մեծ չափի արտադրական գծերի մասշտաբի տնտեսությունը, որը կարտացոլվի, և ներկայիս ներքին 6 դյույմանոց զանգվածային արտադրության ժամանակային բացը կրճատվել է մինչև 7 տարի: Վաֆլիի ավելի մեծ չափը կարող է հանգեցնել առանձին չիպերի քանակի աճի, բարելավելու արտադրողականության մակարդակը և նվազեցնելու եզրային չիպերի համամասնությունը, իսկ հետազոտությունների և զարգացման արժեքը և արտադրողականության կորուստը կպահպանվեն մոտ 7%-ի սահմաններում, այդպիսով բարելավելով վաֆլիի օգտագործումը:
Սարքի նախագծման հետ կապված դեռևս շատ դժվարություններ կան
SiC դիոդի առևտրայնացումը աստիճանաբար բարելավվել է, ներկայումս մի շարք տեղական արտադրողներ նախագծել են SiC SBD արտադրանք, միջին և բարձր լարման SiC SBD արտադրանքները լավ կայունություն ունեն, տրանսպորտային միջոցների OBC-ում SiC SBD+SI IGBT-ի օգտագործումը կայուն հոսանքի խտություն է ապահովում: Ներկայումս Չինաստանում SiC SBD արտադրանքի արտոնագրային նախագծման հարցում որևէ խոչընդոտ չկա, և արտասահմանյան երկրների հետ տարբերությունը փոքր է:
SiC MOS-ը դեռևս բազմաթիվ դժվարությունների է հանդիպում, SiC MOS-ի և արտասահմանյան արտադրողների միջև դեռևս կա անջրպետ, և համապատասխան արտադրական հարթակը դեռևս կառուցման փուլում է: Ներկայումս ST, Infineon, Rohm և այլ 600-1700V SiC MOS-ները հասել են զանգվածային արտադրության և կնքվել ու առաքվել են բազմաթիվ արտադրական արդյունաբերությունների հետ, մինչդեռ ներկայիս տեղական SiC MOS նախագծումը հիմնականում ավարտված է, մի շարք նախագծող արտադրողներ աշխատում են գործարանների հետ վաֆլիի հոսքի փուլում, և հետագայում հաճախորդի ստուգումը դեռ որոշ ժամանակ է պահանջում, ուստի մեծածավալ առևտրայնացումից դեռ երկար ժամանակ կա:
Ներկայումս հարթ կառուցվածքը հիմնական ընտրությունն է, իսկ խրամատի տեսակը լայնորեն կիրառվում է բարձր ճնշման դաշտում ապագայում: Հարթ կառուցվածքի SiC MOS արտադրողները շատ են, հարթ կառուցվածքը հեշտ չէ տեղային խափանումներ առաջացնել ակոսի համեմատ, ինչը ազդում է աշխատանքի կայունության վրա, 1200 Վ-ից ցածր շուկայում ունի կիրառման լայն շրջանակ, և հարթ կառուցվածքը համեմատաբար պարզ է արտադրության առումով՝ բավարարելով արտադրելիության և ծախսերի վերահսկման երկու ասպեկտները: Ակոսային սարքն ունի ծայրահեղ ցածր պարազիտային ինդուկտիվության, արագ միացման արագության, ցածր կորստի և համեմատաբար բարձր արդյունավետության առավելություններ:
2--SiC վաֆլի նորություններ
Սիլիցիումի կարբիդի շուկայի արտադրության և վաճառքի աճ, ուշադրություն դարձրեք առաջարկի և պահանջարկի միջև կառուցվածքային անհավասարակշռությանը


Բարձր հաճախականության և բարձր հզորության հզոր էլեկտրոնիկայի շուկայական պահանջարկի արագ աճի հետ մեկտեղ, սիլիցիումային կիսահաղորդչային սարքերի ֆիզիկական սահմանափակման խնդիրը աստիճանաբար դարձել է ակնառու, և սիլիցիումի կարբիդի (SiC) կողմից ներկայացված երրորդ սերնդի կիսահաղորդչային նյութերը աստիճանաբար արդյունաբերականացել են: Նյութական կատարողականի տեսանկյունից, սիլիցիումի կարբիդն ունի սիլիցիումային նյութի համեմատ 3 անգամ մեծ գոտիական բացվածքի լայնություն, 10 անգամ մեծ կրիտիկական էլեկտրական դաշտի ճեղքման ուժգնություն, 3 անգամ մեծ ջերմային հաղորդունակություն, ուստի սիլիցիումի կարբիդային հզորության սարքերը հարմար են բարձր հաճախականության, բարձր ճնշման, բարձր ջերմաստիճանի և այլ կիրառությունների համար, նպաստում են հզոր էլեկտրոնային համակարգերի արդյունավետության և հզորության խտության բարելավմանը:
Ներկայումս SiC դիոդները և SiC MOSFET-ները աստիճանաբար մուտք են գործել շուկա, և կան ավելի հասուն արտադրանքներ, որոնցից SiC դիոդները լայնորեն օգտագործվում են սիլիցիումային դիոդների փոխարեն որոշ ոլորտներում, քանի որ դրանք չունեն հակադարձ վերականգնման լիցքի առավելությունը։ SiC MOSFET-ը նաև աստիճանաբար օգտագործվում է ավտոմոբիլային, էներգիայի կուտակման, լիցքավորման կույտի, ֆոտովոլտային և այլ ոլորտներում։ Ավտոմոբիլային կիրառությունների ոլորտում մոդուլյարացման միտումը գնալով ավելի ակնառու է դառնում, SiC-ի գերազանց կատարողականությունը պետք է հենվի առաջադեմ փաթեթավորման գործընթացների վրա՝ տեխնիկապես համեմատաբար հասուն պատյանի կնքման հետ որպես հիմնական ուղղություն, ապագան կամ պլաստիկ կնքման զարգացման համար, դրա անհատականացված մշակման բնութագրերը ավելի հարմար են SiC մոդուլների համար։
Սիլիցիումի կարբիդի գնի անկման արագությունը կամ անհավատալիորեն անհամեմատելի

Սիլիցիումի կարբիդային սարքերի կիրառումը հիմնականում սահմանափակվում է բարձր գնով, SiC MOSFET-ի գինը նույն մակարդակի տակ 4 անգամ ավելի բարձր է, քան Si-ի վրա հիմնված IGBT-ինը, դա պայմանավորված է նրանով, որ սիլիցիումի կարբիդի գործընթացը բարդ է, որի դեպքում միաբյուրեղի և էպիտաքսիալ աճը ոչ միայն վնասակար է շրջակա միջավայրի համար, այլև աճի տեմպը դանդաղ է, և միաբյուրեղի մշակումը հիմքի մեջ պետք է անցնի կտրման և հղկման գործընթացով: Հիմնվելով իր նյութական բնութագրերի և անհասուն մշակման տեխնոլոգիայի վրա, տեղական հիմքի բերքատվությունը 50%-ից պակաս է, և տարբեր գործոններ հանգեցնում են հիմքի և էպիտաքսիալ բարձր գների:
Սակայն, սիլիցիումի կարբիդային սարքերի և սիլիցիումի վրա հիմնված սարքերի արժեքի կազմը տրամագծորեն հակառակն է. առջևի խողովակի հիմքի և էպիտաքսիալ ծախսերը կազմում են ընդհանուր սարքի համապատասխանաբար 47%-ը և 23%-ը, ընդհանուր առմամբ մոտ 70%, հետևի խողովակի սարքի նախագծման, արտադրության և կնքման կապերը կազմում են ընդամենը 30%-ը, սիլիցիումի վրա հիմնված սարքերի արտադրության արժեքը հիմնականում կենտրոնացած է հետևի խողովակի վաֆլի արտադրության մեջ՝ մոտ 50%, իսկ հիմքի արժեքը՝ ընդամենը 7%: Սիլիցիումի կարբիդի արդյունաբերության շղթայի գլխիվայր արժեքի երևույթը նշանակում է, որ վերևի խողովակի էպիտաքսիալ արտադրողներն ունեն խոսելու հիմնական իրավունք, ինչը ներքին և արտասահմանյան ձեռնարկությունների դասավորության բանալին է:
Շուկայի դինամիկ տեսանկյունից, սիլիցիումի կարբիդի արժեքի նվազեցումը, բացի սիլիցիումի կարբիդի երկար բյուրեղի և կտրատման գործընթացի բարելավումից, նշանակում է նաև վաֆլիի չափի ընդլայնում, որը նաև անցյալում կիսահաղորդիչների զարգացման հասուն ուղի է եղել։ Wolfspeed-ի տվյալները ցույց են տալիս, որ սիլիցիումի կարբիդի հիմքի 6 դյույմից մինչև 8 դյույմ արդիականացումը կարող է բարձրացնել որակյալ չիպերի արտադրությունը 80%-90%-ով և նպաստել արտադրողականության բարձրացմանը։ Կարող է միավորի համակցված արժեքը կրճատել 50%-ով։
2023 թվականը հայտնի է որպես «8 դյույմանոց SiC առաջին տարի»։ Այս տարի տեղական և արտասահմանյան սիլիցիումի կարբիդի արտադրողները արագացնում են 8 դյույմանոց սիլիցիումի կարբիդի արտադրության ընդլայնումը, ինչպիսին է Wolfspeed-ի 14.55 միլիարդ ԱՄՆ դոլարի խելահեղ ներդրումը սիլիցիումի կարբիդի արտադրության ընդլայնման համար, որի կարևոր մասը 8 դյույմանոց SiC ենթաշերտի արտադրության գործարանի կառուցումն է։ Մի շարք ընկերությունների 200 մմ SiC մերկ մետաղի ապագա մատակարարումն ապահովելու համար Domestic Tianyue Advanced-ը և Tianke Heda-ն նույնպես երկարաժամկետ պայմանագրեր են կնքել Infineon-ի հետ՝ ապագայում 8 դյույմանոց սիլիցիումի կարբիդային ենթաշերտեր մատակարարելու համար։
Այս տարվանից սկսած՝ սիլիցիումի կարբիդի աճը 6 դյույմից կարագանա մինչև 8 դյույմ։ Wolfspeed-ը կանխատեսում է, որ մինչև 2024 թվականը 8 դյույմանոց հիմքի չիպի միավորի արժեքը՝ համեմատած 2022 թվականի 6 դյույմանոց հիմքի չիպի միավորի արժեքի հետ, կնվազի ավելի քան 60%-ով, և արժեքի անկումը կընդլայնի կիրառման շուկան, նշվում է Ji Bond Consulting-ի հետազոտական տվյալների մեջ։ 8 դյույմանոց արտադրանքի ներկայիս շուկայական մասնաբաժինը կազմում է 2%-ից պակաս, և կանխատեսվում է, որ շուկայական մասնաբաժինը կաճի մինչև մոտ 15% մինչև 2026 թվականը։
Իրականում, սիլիցիումի կարբիդային հիմքի գնի անկման տեմպը կարող է գերազանցել շատերի երևակայությունը, 6 դյույմանոց հիմքի ներկայիս շուկայական առաջարկը կազմում է 4000-5000 յուան/հատ, տարեսկզբի համեմատ զգալիորեն նվազել է, կանխատեսվում է, որ հաջորդ տարի կնվազի 4000 յուանից ցածր։ Հարկ է նշել, որ որոշ արտադրողներ՝ առաջին շուկան գրավելու համար, իջեցրել են վաճառքի գինը մինչև ներքևի արժեքի գիծը։ Բացվել է գնային պատերազմի մոդելը, որը հիմնականում կենտրոնացած է սիլիցիումի կարբիդային հիմքի մատակարարման վրա, որը համեմատաբար բավարար է եղել ցածր լարման ոլորտում, ներքին և արտասահմանյան արտադրողները ագրեսիվորեն ընդլայնում են արտադրական հզորությունները կամ թույլ են տալիս, որ սիլիցիումի կարբիդային հիմքի գերմատակարարման փուլը հասնի պատկերացվածից շուտ։
Հրապարակման ժամանակը. Հունվար-19-2024
